전자 제품이 소형화 및 고밀도 집적화를 향해 계속 진화함에 따라 BGA(볼 그리드 어레이) 패키징은 높은 I/O 핀 밀도 연결을 달성할 수 있는 능력으로 인해 스마트폰 및 항공우주 시스템과 같은 장치의 핵심 패키징 형태가 되었습니다. BGA와 인쇄 회로 기판(PCB) 사이의 솔더 조인트는 작은 크기(일반적으로 직경 0.3~0.8mm)이지만 전기 신호 전도 및 기계적 구조 안정성을 유지하는 중요한 노드입니다. 품질은 전자 장치의 장기적인 신뢰성을 직접적으로 결정합니다. 따라서 PCBA 슬라이싱 분석은 BGA 솔더 조인트 품질을 검사하는 핵심 방법이 되었습니다.
이 분석은 다음 세 가지 유형의 지표를 탐지하는 데 중점을 둡니다.
- IMC 레이어: 일반적으로 두께는 2~5μm이다. 지나치게 두꺼운 층은 열 순환 균열을 일으킬 수 있고, 연속되지 않은 층은 박리의 위험이 있을 수 있습니다.
- 솔더 조인트 보이드: 플럭스의 증발 부족으로 인해 비율이 15%를 초과하면 열 전도 및 하중 지지 용량이 감소하거나 신호 중단이 발생합니다.
- 인터페이스 균열: 열적/기계적 스트레스로 인해 전류가 차단되고 장비 동결 및 치명적인 고장의 중요한 원인이 됩니다.
PCBA 슬라이싱 분석은 솔더 조인트의 품질을 정밀하게 추적할 수 있으며, 대량 생산 스크리닝뿐만 아니라 고장 위치 지원에도 사용되어 전자 장치의 기능과 무결성을 보장하는 핵심 지원 역할을 합니다.
다음은 약 80μm 크기의 솔더 조인트에 대한 BGA 샘플 준비 계획의 예입니다. 참고로 다음 계획을 참고하세요.
1️⃣ : P1200 금속 사포를 사용하여 목표 위치 가장자리까지 연마합니다.
2️⃣ : P2000 금속 사포를 사용하여 목표 위치까지 연마합니다.
3️⃣ : 사용 SC-JP 연마포 연마용 다이아몬드 연마액 3μm.
4️⃣ : 사용 ET-JP 연마포 연마용 다이아몬드 연마액 1μm.
5️⃣ : 사용 ZN-ZP 연마 천 최종연마용 SO-A439 50nm 실리카 연마액
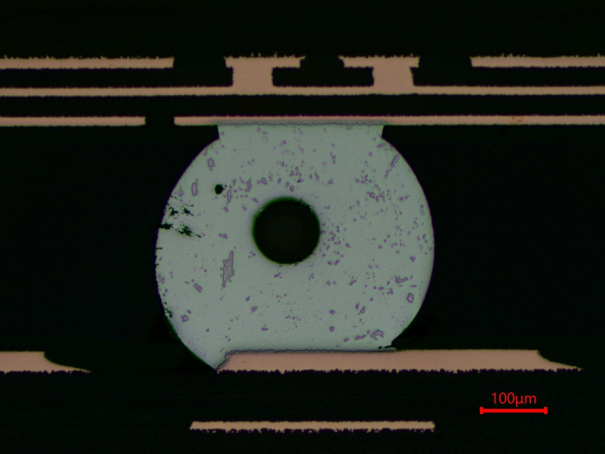
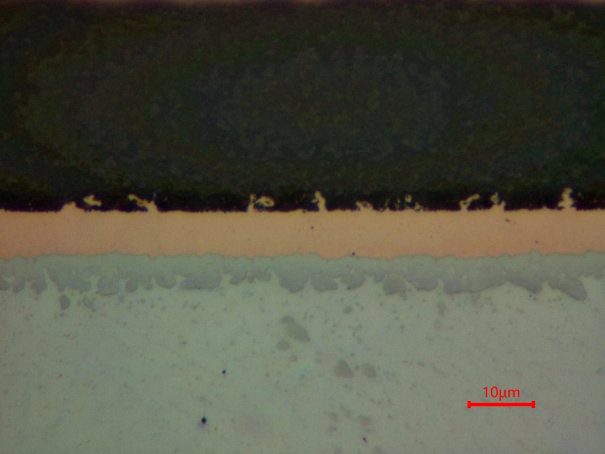
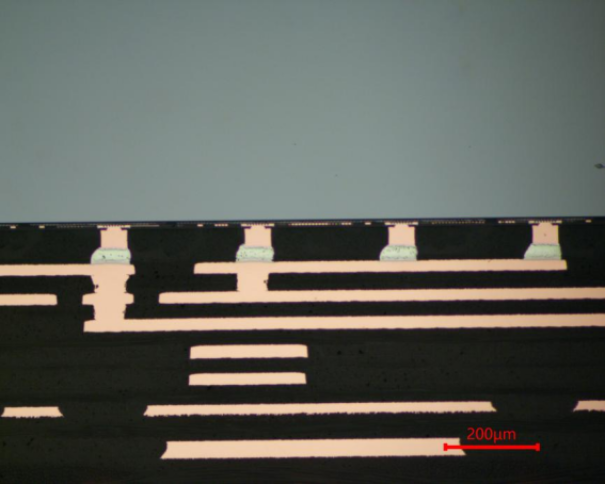
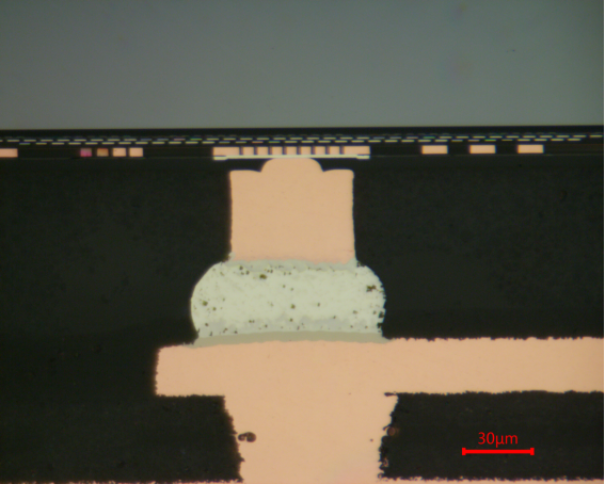



.png?imageView2/2/w/400/format/jpg/q/75)
.png?imageView2/2/w/400/format/jpg/q/75)
.png?imageView2/2/w/400/format/jpg/q/75)



.jpg?imageView2/2/w/400/format/jpg/q/75)











